1. 서 론
다양한 산화막들은 반도체 소자에서 field oxide, 보호 막, 층간 절연막, 그리고 게이트 절연막 등으로 응용 되 고 있으며, 이러한 이유로 MOSFET이 발명된 후 지금 까지 수 십 년간 산화막 제조와 평가에 대한 연구가 활 발히 진행되고 있다.
이러한 산화막 중 알루미늄 산화막은 물리적으로나 화 학적으로 매우 안정한 산화물로써 절연재, 절삭공구, 전 자회로 기판, 의료용 기기 등 넓은 공학 및 산업영역에 응용 가능한 재료이다. 또한 물리적 화학적으로 안정하 므로 플라즈마 분위기에서도 식각이 잘 되지 않는 특징 을 가지고 있다. 일반적인 특성으로는 알칼리 이온이나 불순물들에 대한 높은 확산 저항성, 비교적 높은 유전 율, 높은 열 전달 특성 및 넓은 파장대의 투과성 등이 있다.1) 이러한 특성 때문에 알루미늄 산화막은 게이트 절 연막으로 또는 DRAM2,3)의 유전 박막으로 이용 될 수 있다.
Al2O3막을 증착 시킬 수 있는 방법으로는 MBE(molecular beam epitaxy), CVD(chemical vapor deposition), PEMOCVD(plasma enhanced metal organic chemical vapor deposition), reactive sputtering, 원자빔 증착(atomic beam deposition), ALD(atomic layer deposition) 등이 있다.4) 이 중에서 ALD법은 연속적 포화 표면반응(saturative surface reaction)을 기반으로 한 자기제한(selflimiting) 반응 특성을 지니고 있고 저온공정이 가능하며 매우 우수한 두께 균일도를 나타내며 particle의 생성 또 한 적다.4,5) 또한, ALD법은 반응가스를 분할 주입하여 반 복적으로 증착하는 방법으로 제1반응가스의 주입, 퍼지 (purge), 제2반응가스의 주입, 퍼지를 한 사이클로 정의 한다. 이 증착 법은 반응가스들 사이의 기상반응을 억 제하고 반응가스들의 표면흡착과 표면반응을 이용하는 증 착 방법으로써 증착 사이클 수의 조절만으로 정확한 두 께의 제어가 용이하고 높은 단차를 가지는 곳의 도포에 우수한 특성을 보인다.6,7) 하지만, 통상적인 ALD법은 좁 은 process window와 낮은 생산성을 포함한 여러 가지 문제점들을 가지고 있다. 그러한 문제점들을 해결하기 위 해 반응성 향상, 불순물 감소, 넓은 process window 그 리고 박막 밀도 향상이 기대되는 새롭게 설계된 증착 기 술인 ECR-PECVD법을 적용하였다.8,9) 본 연구에서 사용 한 ECR-plasma는 2.45 GHz의 고주파수에서 전자를 가 속시킬 수 있기 때문에 plasma의 효율을 향상시킬 수 있 으며, 박막의 증착 속도 향상 및 상온에서 증착할 수 있 다는 장점을 가지고 있다.10,11) ECR-PEALD법을 적용하 여 증착 속도를 향상시킴과 동시에 상온 증착을 통한 Al2O3 박막을 thermal ALD법으로 증착한 박막의 물리 적, 화학적, 전기적 특성을 비교 분석하였다.
2. 실험 방법
Thermal ALD는 전구체인 TMA(TriMethylAluminum) 와 반응체인 H2O, 수송 및 제거 기체로서 N2 가스를 사 용하였으며 공정압력 200 mTorr와 280 °C의 온도에서 증 착하였다. cycle구성은 TMA-N2-H2O-N2 순으로 순차적으 로 주입하고 각 단계를 격리하였으며 주입시간은 각각 0.2/45/0.2/90초이다. 기판은 p-Si (100) wafer를 사용하 였다.
첫번째로 전구체인 TMA를 챔버 내로 N2 가스와 함 께 주입하여 Si박막의 OH와 반응시킨다. (1)
이 때, 생기는 부산물인 메탄(CH4)과 과잉 TMA를 N2 가스로 제거한 후 H2O를 주입하여 기판 위의 Si-O-Al (CH3)2(s)와 반응시킨다. (2)
이어서 N2 가스로 생성된 메탄(CH4)과 과잉 H2O를 제 거한다.
ECR-PEALD는 전구체인 TMA와 O2 가스를 반응체로 하였으며 수송 및 제거 기체로는 Ar 가스를 사용하였다. ECR-PEALD법의 경우, plasma에 의해 질소가 분해되어 박막 내에 들어갈 수 있기 때문에 ECR-PEALD법에서 는 Ar 가스를 사용하였다. 공정압력은 200 mTorr와 상온 증착하였다. 또한 plasma power는 1 kW이다. TMA-Ar- O2-Ar 순으로 주입하고 주입시간은 0.2/30/0.2/30초이다.
Al2O3의 전기적 특성을 위해 p-Si 기판 위에 thermal evaporator를 이용하여 하부 전극Ti (10 nm)/Cu (100 nm) 을 증착시키고 thermal ALD와 ECR-PEALD법을 이용하 여 Al2O3 40 nm를 각각 증착하였다. Lift-off로 patterning을 한 후 thermal evaporator를 이용하여 Ti (10 nm)/ Cu (100 nm)의 상부전극을 증착하여 capacitor를 제작하 였다.
3. 결과 및 고찰
Fig. 1은 Si 기판 위에 thermal ALD법으로 280 °C와 ECR-PEALD법으로 상온에서 증착한 Al2O3 박막을 XRD 를 이용하여 박막의 상을 분석한 결과이다. 두 방법 모 두 비정질 상을 보였다. 또한 Table 1과 같이 ellipsometry를 이용한 Al2O3 박막의 굴절률(n)과 흡광계수(k)를 분석한 결과이다. 두 박막 모두 굴절률 ~1.69와 ~1.68 로 유사한 값을 가졌다.
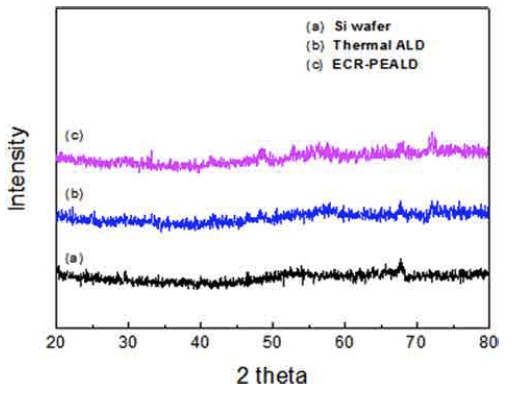
Fig. 1
Grazing incidence angle X-ray diffraction(GIAXRD) patterns of (a) Si wafer (b) thermal ALD thin films (c) ECR-PEALD thin films.
Fig. 2는 Si 기판 위에 thermal ALD법과 ECR-PEALD 법을 이용하여 각각 60 nm씩 증착한 Al2O3 박막의 단면 을 TEM으로 본 것이다. 두 박막 모두 치밀하고 균일하 게 증착 된 것을 볼 수 있었다.
Fig. 3은 AFM을 이용하여 thermal ALD 법과 ECRPEALD 법을 이용하여 각각 증착한 박막 표면의 roughness를 측정하였다. Thermal ALD 법으로 증착한 박막 의 경우는 RMS = 0.32 nm로 매끄러운 표면의 박막을 얻 을 수 있었지만, ECR-PEALD 법으로 증착한 박막의 경 우 RMS = 5 nm 정도로 thermal ALD법의 박막에 비해 상대적으로 거친 표면을 나타내고 있는데 이는 알루미 늄 전구체인 TMA가 완전히 분해되지 않았기 때문에 거 친 표면이 된 것으로 볼 수 있다.
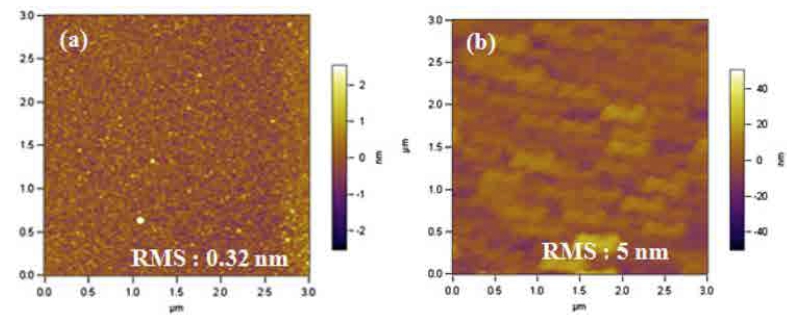
Fig. 3
AFM images and surface roughness measured in a 30 × 30 μm area on the top surface of the Al2O3 thin films. (a) thermal ALD and (b) ECR-PEALD.
Fig. 4에 XPS의 depth profiling을 통한 조성 분석을 하였다. Fig. 4(a)는 thermal ALD법으로 280 °C 증착한 Al2O3 박막이다. Fig. 4(b)는 ECR-PEALD법으로 상온에 서 증착한 Al2O3 박막이다. Table 2에서 Al2O3 박막 내의 Al 2p, O 1s, C 1s, Si 2p를 depth profiling한 값이다. 이 결과를 보면, thermal ALD법으로 증착한 Al2O3 박 막은 Al과 O 이외에 다른 물질은 존재하지 않는 것을 알 수 있었으며 Al : O = 42.2 % : 57.8 %로 거의 유사한 화학양론비를 보였다. 하지만 ECR-PEALD법으로 증착한 Al2O3 박막은 Al : O = 39.40 % : 58.27 % 이외에도 C = 2.31 %로 소량 검출되었다. 탄소가 남아 있는 원인은 ECR-PEALD법은 상온에서 산소플라즈마를 이용한 증착 이었기 때문에 알루미늄의 전구체인 TMA가 완전히 분 해가 되지 않아 박막에서 검출된 것이라 생각된다. 이 러한 잔여 탄소는 박막의 누설전류를 증가시키며, 막질 의 저하를 초래한다. 따라서 우수한 질의 박막을 증착 하기 위해서는 탄소의 영향을 줄이는 것이 중요하다.1) 초 기 진공도를 높이고, Al2O3 박막의 증착 과정에서 충분 한 퍼징(purging)과 적절한 소스 주입량을 결정하여 완벽 한 반응을 유도한다면 thermal ALD법으로 증착한 Al2O3 박막처럼 우수한 막질의 박막을 증착할 수 있을 것이다.
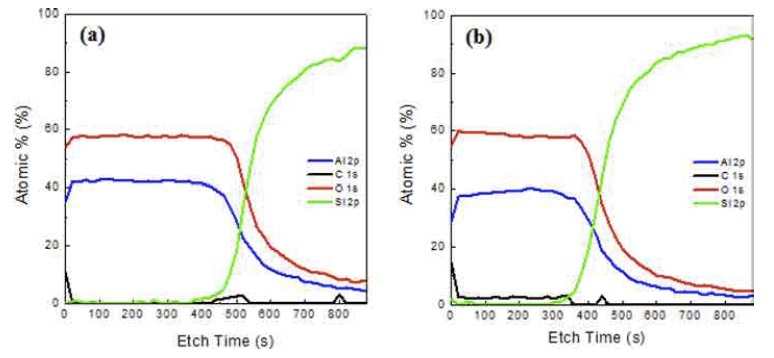
Fig. 4
The chemical compositions of the thin films were measured by X-ray photoemission spectrometry(XPS). (a) thermal ALD and (b) ECR-PEALD.
Fig. 5는 thermal ALD법과 ECR-PEALD법으로 증착한 Al2O3 박막의 XPS survey spectra 이며 Fig. 6은 284.8 eV의 C 1s peak을 기준으로 (a) Si 2p, (b) C 1s, (c) Al 2p, (d) O 1s의 binding energy를 각각 나타내었다. Table 3에서 Al2O3 박막의 O 1s와 Al 2p의 binding energy 는 증착법과 관계없이 유사한 값을 갖는다.

Fig. 6
(a) Si 2p, (b) C 1s, (c) Al 2p, (d) O 1s core level spectra of the thermal ALD and ECR-PEALD deposited Al2O3 film.
Fig. 7는 thermal ALD법과 ECR-PEALD법으로 각각 유리 기판 위에 증착한 Al2O3 박막과 유리를 가시광선 파장대인 550 nm를 기준으로 투과도를 측정한 결과 88 ~89 %의 유사한 투과도를 나타내었다. Al2O3 박막내의 전 하 분포를 정성, 정량적으로 평가하기 위해 Si 기판 위에 Ti/Cu를 thermal evaporation방법으로 각각 10 nm, 100 nm를 증착하고 40 nm의 Al2O3를 각각 두 가지 ALD법 으로 증착 후 photo-lithography 공정으로 패터닝을 진행 하였다. Ti/Cu (0.1 μm * 0.1 μm = 0.01 μm2)를 각각 10 nm / 100 nm 증착하여 MOM구조로 제작하였다. 이 후 박막의 안정화를 위해 Ar 분위기에서 300 °C로 30분 동 안 열처리를 실시하였다. 전기적 특성을 분석하기 위해 서 C-F / C-V 측정과 I-V 측정을 실시하였다. Fig. 8과 Table 4은 주파수 100 kHz 기준으로 C-F 측정 결과이 다. 성장된 박막의 C-F 측정 결과로부터 증착된 박막은 6.45~7.07의 유전율 값을 가지는 것으로 나타났으며, capacitance( pF) 값은 15.23/15.65으로 매우 유사한 값을 나 타내었다. Fig. 9는 −5 ~ 5 V의 전압에서의 capacitance (pF) 를 측정한 C-V 측정 결과이다. C-F와 마찬가지로 thermal ALD법으로 증착한 Al2O3박막과 ECR-PEALD법 으로 증착한 Al2O3박막은 유사한 capacitance(pF) 값을 갖는다. 그리고 전압에 따라 일정한 capacitance와 hysteresis 차이가 없는 특성을 나타내었다. 하지만 Fig. 10 에서 성장된 Al2O3 박막의 누설전류 특성을 조사한 결 과 thermal ALD법으로 증착한 박막의 경우 −10 ~ 10 V 범위에서 ~10−9 A/cm2로 우수한 절연막 형성을 보여주고 있지만 ECR-PEALD법으로 증착한 박막의 경우는 −10 ~ 10 V범위에서 ~10−7 A/cm2으로 상대적으로 높은 누설 전류 값을 나타내었다. 상대적으로 높은 누설 전류 값 을 갖는 이유는 XPS 분석을 통해서도 알 수 있듯이 박 막 내에 탄소가 존재하여 박막의 누설전류를 증가시킨 원인으로 작용하는 것으로 여겨지지만 C-V와 C-F 측정 결과를 통하여 C-F / C-V등의 유전 특성에는 영향을 주 지 않는 것을 알 수 있다.

Fig. 8
Capacitance - Frequency curves of (a) Al2O3 thin film deposited by thermal ALD and (b) Al2O3 thin film deposited by ECR-PEALD.
4. 결 론
본 논문에서는 thermal ALD와 ECR-PEALD법으로 TMA, H2O, O2를 이용하여 Al2O3 박막을 증착 시킨 후 그 박막의 특성을 비교하였다.
ECR-PEALD법은 thermal ALD 법과 비교하였을 때, 상온에서 증착이 가능하며, 기존의 thermal ALD법에 비 해 빠른 증착 속도를 가지고 있다. 또한, 기존의 ALD 법으로 증착한 박막과 유사한 물리적·전기적 특성을 얻 을 수 있었다. 하지만 thermal ALD법으로 증착된 Al2O3 박막에서는 탄소가 검출되지 않았으며, 박막 표면이 매 끄러운 것을 볼 수 있었다. 반면에, ECR-PEALD법으 로 증착된 Al2O3 박막은 알루미늄의 전구체인 TMA (Trimethylaluminum)가 완전히 분해가 되지 않아 박막에 서 소량의 탄소가 검출되었다. 이러한 잔여 탄소는 박 막의 누설 전류를 증가시키며, 표면의 거칠기에 영향을 미치는 것으로 볼 수 있다. 따라서 plasma power 및 챔 버 내 기판의 거리 조절 등과 같은 공정 시스템의 최 적화를 통해 위의 특성들이 개선될 것으로 예상된다.