1. 서 론
조밀육방정(hcp)구조를 갖는 AlN (질화알루미늄)은 우 수한 내열성과 기계적강도가 높기 때문에 고온용 재료 로서 이용되고 있으며, 우수한 압전특성이 주목되고 있 다.1) 특히 고주파용 SAW (surface acoustic wave, 탄성 표면파 디바이스) 소자로의 응용은 유망하며, ZnO의 대 체 재료로서도 가능하다.2) 일반적으로 탄성표면파의 여 진 및 검출용 소자로서는 스퍼터링방법을 이용한 c축 배 향막을 사용한다. 따라서 c축 배향성이 우수한 박막을 제 작하기 위하여 여러가지 스퍼터링방법이 검토되었다.3,4) 스 퍼터링 분위기는 질소가스압력, 증착할 때의 기판온도, 외 부자계가 막질에 미치는 영향 등이 검토되는 가운데, 어 떠한 조건에서는 스퍼터링 방법으로 제작한 박막이 기 판으로부터 탈락되거나 박막자체 깨짐이 발생하는 등의 현상이 보고되었다.4) 이와 같은 현상은 제작된 박막 내 에 발생하는 잔류응력이 원인이라고 판단되며, 디바이스 로서 기계적으로도 안정한 박막을 제작하기 위해서는 박 막 내부의 잔류응력 발생원인 및 거동을 충분히 파악할 필요가 있다.
결정성재료의 잔류응력측정은 X선을 이용한 응력측 정법이 유용하며, 측정 대상물의 결정배향이 불규칙하 다면, 일반적으로 sin2ψ법을 이용하여 응력을 해석하는 방 법이 있다.5) 그러나 연성재료와 같이 우선방위를 가지는 재료는 일반적으로 sin2ψ선도가 비선형으로 되어 상기한 방법으로는 해석에 어려움이 있다.6,7) 입방정격자인 저탄 소 냉간압연재는 (211)[011], (111)[211], (100) [011]의 전형적인 압연집합조직을 나타내지만, 이와 같은 경우, 동 일한 결정 내에 속하는 결정군을 이용하면 측정되는 격 자변형은 sin2ψ선도 상에서 선형으로 되며, 이 직선의 구 배로부터 응력을 계산하는 방법이 제안되었다.8,9)
본 연구의 대상인 AlN박막은 위에서 서술한 것과 같 이 조밀육방구조이며, c축이 기판 면의 법선방향으로 배 향되는 우선배향을 나타내는 재료이다. 본 연구의 목적 은 이와 같은 경우에 대하여 등방평면 응력상태와는 다 른 (hk∙l)의 격자변형을 해석하고, sin2ψ법을 대체하는 새 로운 잔류응력 측정방법을 검토하는 것이다.
2. 이방성 재료의 응력-변형 관계식
2.1. 응력과 변형과의 관계
시료계(Si), 결정계(Ci), 그리고 응력측정 장치에 따라서 결정되는 실험실계(Li)로부터 구성되는 3개의 좌표계를 Fig. 1과 같이 결정하였다.

Fig. 1
Three coordinate systems consisting of a sample system, a crystal system and a laboratory system determined according to the stress measuring equipment.
그리고 이와 같은 각 좌표계 간의 좌표변환 매트릭스 를 Fig. 2와 같이 하면, 텐서(tensor) 변환축에 의해 어 떤 1개의 결정면(hkl)의 법선방향 변형 과 결정계의 변 형성분 의 관계는
로 나타낼 수 있다.
특히, 결정계에 대한 응력과 변형과의 관계는 단결정 탄성 컴플라이언스 을 이용하면, 일반화된 Hooke의 법칙으로부터
로 된다. 또한, 시료계로부터 결정계로 좌표변환에 의한 양쪽 좌표계에서의 응력성분 사이에는
의 관계가 성립한다. 따라서 식(1), 식(2) 및 식(3)으로 부터
을 구할 수 있으며, 여기에서
이라고 하면, 식 (4)는
으로 된다. 즉, 식 (5)에서 정의된 을 이용하면, X 선적으로 정의된 격자변형 이 시료계에서의 응력성분 을 사용하여 표현할 수 있게 된다.
2.2. 결정조직상태 및 회절선과 좌표 간의 관계
이후에 언급할 결과에서 알 수 있듯이 글래스기판 상 의 AlN박막은 c축 배향, 즉, hcp구조의 c축(C3축)이 기 판 면에 거의 수직으로 배열된 조직이다. 그리고 결정 은 미세하며, 각각의 결정방위는 c축 주변의 회전자유도 를 가지고 있다. 즉, 시료표면의 법선방향으로부터 본 결 정방위는 불규칙하다.
측정에 이용한 회절선은 00·1, 10·1, 10·2 및 10·3 이 다. 이와 같은 면의 법선의 스테레오 투영도에서의 극은 Fig. 3에 나타낸 것과 같이 [ 1 2·0] 상에 있으며, [10∙0] 방향을 시료의 S1축으로 일치시키면, 상기한 회절선은 [12·0]축이 시료의 S2축, 즉, 실험실계에서는 L2축 (ψ축)에 일치하도록 결정으로부터의 회절을 받게 된다.

Fig. 3
The relationship between the sample system and the laboratory system, and the crystal system and the laboratory system (L3).
또한, 이 경우 시료계(Si)와 결정계(Ci)는 완전하게 일 치하며,
이다. 시료계(Si)와 실험실계 (Li)의 관계 ω 및 결정계(Ci) 와 실험실계의 관계 γ는 Fig. 3으로부터 이다.
2.3. 스퍼터링 방법으로 제작한 AlN 박막의 잔류응 력 해석법
기판 위에 스퍼터링 방법으로 증착된 얇은 막을 고려 하여, 박막 내의 응력상태를
로 표현되는 등방평면 응력상태라고 가정하면, 식(6)은 로 기술된다.
결정의 탄성 컴플라이언스의 텐서 표시 Sijkl와 매트릭 스 표시 Sij의 대응관계는  을 이용하고, 특히 결정구조가 조밀육방정인 경우 의 0이 아닌 성분이 인 것을 고려하면, 식 (5)는 로 된다. 이 식으로부터 식 (10)은 으로 되며, 식 (8)에서 나타낸 γij의 성분 관계인 을 이용하면 식 (13)은 다음 식으로 변환된다.
을 이용하고, 특히 결정구조가 조밀육방정인 경우 의 0이 아닌 성분이 인 것을 고려하면, 식 (5)는 로 된다. 이 식으로부터 식 (10)은 으로 되며, 식 (8)에서 나타낸 γij의 성분 관계인 을 이용하면 식 (13)은 다음 식으로 변환된다.
또한, ψ는 Fig. 3에 나타낸 것과 같이 시료표면의 법 선방향으로부터 측정한 각도이지만, 2.2.절의 결정상태 정의로부터 결정의 ( 00· 1 )면과 (hk· l)면과의 사이각 과 같다.
식 (15)가 의미하는 것은 (hk· l)면의 법선방향 변형은 sin2ψ에 대해서 선형관계가 있는 것이고, 어떠한 것이든 hk· l 회절선의 프로파일을 특정한 ψ각에 대해서 구할 수 있다면, 이 회절각도로부터 결정되는 격자변형 는 sin2ψ에 대해서 선형으로 정리된다는 것을 나타내는 것이다. 이 직선의 구배는 ()이기 때문 에, 단결정의 탄성 컴플라이언스 을 알 수 있다면 다 음 식으로부터 응력값을 계산할 수 있다.
3. 실험방법
3.1. TFT (Two-Facing-Targets) 스퍼터 장치
Fig. 4는 본 실험에 사용된 TFT 스퍼터 장치의 개략 도이다. 타겟 홀더는 수냉장치가 부착되어 있으며, 2개 의 타겟이 한 쌍으로 서로 마주 보게 배치되어 있다.10) 타겟재료는 99.9 % 알루미늄 원판이며, 두께 3mm, 직 경 1 00mm 이다. 타겟의 뒷면에는 영구자석이 장착되어 있기 때문에 자계가 플라즈마를 효율성 좋게 제어하여 낮 은 가스압력으로도 안정된 방전을 얻을 수 있으며, 기판 이 플라즈마 영역의 외부에 위치하기 때문에 높은 에너 지를 갖는 γ 전자나 산소의 (-)이온에 의한 박막표면의 충격이 거의 없는 증착 및 저온 스퍼터링이 가능하다.10)
3.2. AlN 박막의 제작
AlN은 a = 0.31 14 nm, c = 0.4986 nm인 육방구조이며,11)a축 방향의 열팽창계수는 5.27 × 1 0-6/K,12) 융점은 2723 K 이다.13) 기판재료는 열팽창계수가 5.1 × 10-6/K인 BLC 글래스를 사용하였으며, 이것은 제작된 AlN의 열팽창계 수와 거의 유사하다.
Table 1에 증착조건을 나타내었다. 챔버를 진공펌프를 이용하여 2 × 1 0-5 Torr의 진공도로 하였으며, 진공펌프를 작동시킨 상태에서 질소가스를 주입하여 Table 1에 나타 낸 3종류의 질소가스압력상태를 유지하였다. 기판온도는 써머커플을 기판에 부착하여 측정하였으며, 본 실험에서 는 523 K로 고정하였다. 제작한 박막의 두께는 약 2 μm 이다.
3.3. X선을 이용한 AlN박막의 조직형태 및 잔류응 력 측정
측정에 사용한 장치는 집중빔방법을 기본으로 한 측경 법응력측정장치이며, 측정조건은 Table 2와 같다. 박막조 직의 형태조사는 CrKα선을 이용하였으며, ψ=0의 상태에 서 θ-2θ의 조작을 통하여 AlN분말 표준시료와 제작한 박 막과의 회절선을 비교하였다.
잔류응력측정은 CrKα선을 이용하여 Table 3에 나타낸 4개의 회절선에 대한 회절프로파일을 스텝스캐닝으로 계 측하고, 확률밀도함수법14)을 이용하여 피크위치를 결정하 였다. 즉, 모든 회절 프로파일로부터 백그라운드 강도값 을 뺀 후 LP(로렌츠방법을 이용)인자로 보정하고, 최대 강도의 3 /1 0 이상의 강도부분을 정규분포곡선에 근사시 키는 방법을 이용하였다.
식 (15)로부터, (hk․ l)면의 법선변형은 sin2ψ선도 상에 서 선형으로 정리되는 것을 알았다. Fig. 5(a)는 hcp결 정의 표준 스테레오 투영도이며, 00·1극이 중심에 위치 한다. [00·1]방향을 시료표면 법선방향으로 이동시켜, 이 축 주위에 모든 방위를 갖는 결정집합체로 되는 시료에 대한 스테레오 투영은 Fig. 5(b)에 나타낸 것과 같이 중 심대칭인 원을 형성하는 궤적으로 나타난다. 즉, 시료법 선방향에는 00·2 회절선을 얻을 수 있고, ψ각을 변화시 킬 때 시료법선에 대해서 임의의 방위각 φ로, 예를 들 어 10·3, 10·2, 10·1 회절선을 얻을 수 있게 된다. 각 회절선에 대한 회절각 (2θ), ψ각 (sin2ψ값)을 Table 3에 정리하였다. 이 경우, 상기한 바와 같이 ψ각은 회절에 기 여하는 격자면의 법선과 00·1면 법선방향과의 사이각에 일치하며, 다음 식으로 구할 수 있다.
본 연구에서는 (hiki․li)를 (00·1)로 하고, (hjkji․lj)는 상 기한 (10·3), (10·2), (10·1)로서 각각의 결정면 법선의 시료면 법선으로부터의 경사각 ψ를 계산하였다.
상기한 설명에서 알 수 있듯이, 이 방법은 종래의 sin2ψ 법과는 다르며, Table 3에 나타낸 특정한 ψ각에 대해서 각각 다른 hk·l 회절선을 선택해야 한다. 더구나, 이와 같 은 회절선은 2θ값으로 54°에서 1 07°에 걸친 광범위한 영 역에 있다. 단위 변형당 회절선의 피크 이동량은 2θ가 클수록 크기 때문에 양호한 측정정밀도를 얻기 위해서 는 일반적으로 회절각도가 큰 회절선을 이용한다. 회절 각도가 작은 경우는 측정정밀도가 낮거나 여러가지 계 기오차 등의 영향도 있기 때문에, 본 실험에서는 AlN분 말을 비교하기 위하여 표준시료로서 사용하였다. 즉, 각 각의 회절선에 대하여 식 (17)에서 결정된 ψ각에 대해 서 AlN분말과 AlN박막의 회절선 위치를 정확히 측정하 여 다음 식에 의해 각각의 회절면 법선변형 ε(hk·l, ψ) 를 구하였다.
여기서, d(hk․ l, φ) 및 d0(hk․ l, φ)은 각각 AlN박막 및 AlN분말의 회절선 위치로부터 구한 격자면간격 이다.
4. 결과 및 고찰
4.1. 기판상의 AlN박막의 조직형태
Fig. 6은 AlN분말에 대한 XRD측정결과이다. 분말시료 는 양면테이프의 한 쪽면에 접착한 것을 사용하였기 때 문에 회절에 기여하는 분말은 비교적 양이 적기 때문에 회절선 강도는 약하지만, 결정방위는 무방위이기 때문에 모든 회절피크가 나타나 있다.
Fig. 7은 스퍼터링방법으로 증착한 AlN박막의 XRD측 정결과 이다. ψ = 0에서의 θ-2θ 연속 스캐닝 연속측정으 로 구한 것은 2θ = 54.7°에 나타난 00·2 회절선 뿐이며, Fig. 6에 나타난 다른 회절선은 나타나지 않았고, 유일 하게 나타난 00·2 회절선의 강도는 매우 크다.

Fig. 7
XRD measurement result of AlN thin film on BLC on BLC glass deposited by sputtering method (sampling time, 5 sec).
이와 같은 결과로부터 글래스 기판에 스퍼터링방법으 로 증착된 AlN박막은 결정의 c축, 즉, <00·1>을 기판면 에 수직하게 성장시킨 막이라는 것을 알 수 있으며, 더 구나 임의의 각도 φ에서 Table 3에 주어진 각도 ψ에 대 해서 회절선을 구할 수 있고, 그 강도는 각도 φ에 관계 없이 거의 일정하였다. 이것은 박막을 형성하는 결정은 매우 미세한 주상정조직으로 되어 있으며, c축 주변의 결 정방위회전의 자유도를 가지고 있다고 판단된다. 증착조 건을 고려하여도 기판면 내에서 이방성을 갖는다는 것 은 생각할 수 없으며, 이 의미로서 잔류응력도 기판면 내에서 등방적이라고 할 수 있다.
4.2. AlN박막의 잔류응력측정
Fig. 8은 XRD측정결과 중 하나이다. sin2ψ = 0에서 구한 00·2회절의 회절강도는 매우 강하지만, 다른 회절 면으로부터의 회절강도는 00·2회절에 비해서 매우 약하 다. Fig. 5(b)를 참조하면, 00·2회절선에 대해서는 조사 면 내의 모든 결정립이 기여하지만, 다른 회절선에 대 해서는 입사슬릿에서 제한된 부분만이 측정되었기 때문 에 시료면의 법선방향에서 멀어질수록 회절강도는 약하 게 된다. 그러나 Fig. 8에 측정된 강도분포 데이터를 이 용하여 충분한 정밀도로 확률밀도함수에 근사시킬 수 있 었으며, 정확도를 갖는 회절선의 위치결정이 가능하였다.
Fig. 9는 523 K으로 가열한 BLC글래스 기판에 증착 시킨 AlN박막의 잔류응력 측정결과이다. 각 점에 대하 여 3회씩 측정을 실시하였다. ψ = 0을 제외하고 회절강 도는 매우 미약하였기 때문에 측정결과는 편차가 있었 으며, 대략적으로 최소 2승법으로 구한 직선의 구배를 계 산하고 식 ( 1 6)을 이용하여 박막의 잔류응력을 계산하였 다. 여기에서 이용한 단결정의 탄성 컴플라이언스 정수 의 값은 = 0.35 × 1 0-5/MPa, = -0.20 × 10-5/MPa, = 0.30 × 10-5/MPa이다.15)
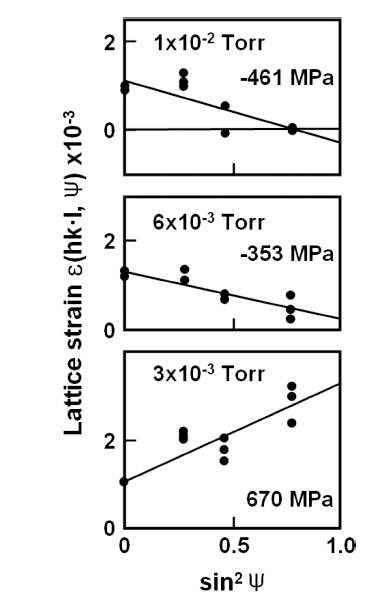
Fig. 9
Residual stress measurement results of AlN thin film deposited on BLC glass substrate heated to 523 K.
질소가스압력이 1 × 10-2 Torr 및 6 × 1 0-3 Torr의 경우 에는 (-)의 구배를 가지며, 각각 -461M Pa 및 -353 MPa 의 압축잔류응력이지만, 3 × 1 0-3 Torr의 경우는 (+)의 구 배를 가지며, 670 MPa의 인장압축응력이다.
Este 등은 실리콘웨이퍼에 스퍼터링방법으로 증착시 킨 AlN박막의 잔류응력을 웨이퍼의 곡률로부터 측정하 였다.16) 그 결과, 잔류응력은 질소가스압력에 좌우되며, 가스압력 0.4 Pa일 때에는 -5 GPa의 큰 압축잔류응력 이, 그리고 가스압력의 증가와 함께 압축잔류응력은 감 소하여, 가스압력이 5 Pa일 때에는 +0.2 GPa의 인장잔류 응력으로 되는 것을 보고하였다. 이와 같은 큰 압축잔 류응력은 원자의 피닝효과에 의한 것이라고 보고되었 다.17,18) 즉, 낮은 가스압력에서는 스퍼터링된 입자가 갖 는 운동에너지는 크며, 이와 같은 입자들은 증착막으로 의 충격확률이 높아져서 숏피닝과 유사한 효과를 일으 킨다. 본 실험에서는 잔류응력의 가스압력의존성은 Este 등16)의 결과와는 반대이지만, 본 실험의 경우, 대향타겟 (TFT)을 이용한 것에 반하여 Este 등은 타겟과 기판이 서로 마주보는 구조로 되어 있다. 타겟과 기판이 서로 마주보는 구조인 경우는 기판이 플라즈마에 노출되기 쉬 운 반면에 대향타겟 구조는 기판이 플라즈마에 직접 노 출되기 어려운 구조이다.19) 따라서 잔류응력의 부호에 대 해서 Este 등의 결과와 직접 비교하는 것은 무리이며, 현 재 시점에서 잔류응력거동을 명확하게 설명할 수는 없다.
가스압력의존에 의한 막질의 관찰결과로서, 비교적 높 은 가스압력에서는 기계적으로 안정한 박막이 제작되었 지만, 6 × 1 0-4 Torr인 낮은 가스압력에서는 크랙이 가거 나 때로는 막이 기판에서 탈락되는 현상이 일어난다고 보고되었다.20) 낮은 가스압력일 때 어떠한 원인에 의해 서 발생된 큰 인장잔류응력에 의한 것이라고 판단된다.
특히, Fig. 9에서 특징적인 것은 낮은 가스압력에서 격 자변형이 (+)쪽으로 이동한다는 것이다. 서로 다른 가스 압력 하에서 제작된 AlN 박막의 EDS측정결과를 보면 Al원자와 N원자의 성분비가 변화한다는 보고가 있다.20) 1 × 10-2 Torr인 경우에 N/Al의 비가 1인 것에 반하여, 6 × 1 0-4 Torr에서는 비가 1 .33이다.18) 즉, 낮은 가스압력 으로 될수록 질소원자가 격자 내에 과잉으로 포함되기 때문에 단위정 팽창이 원인이 되어 X선적으로 격자변형 은 (+)쪽으로 이동한다고 판단된다.
잔류응력의 발생기구를 명확하게 하기 위해서는 광범 위한 조건으로 박막을 제작하여 실험적으로 체계적인 경 향성을 조사할 필요성이 있다고 판단된다. 따라서 X선 회절을 이용한 결정의 배향성이나 성분분석 등의 방법 도 조합하여 잔류응력의 현상을 더욱 명백하게 하여 보 고할 예정이다.
5. 결 론
TFT 스퍼터링 장치를 이용하여 글래스 기판에 제작한 AlN 박막의 조직 및 잔류응력을 X선을 이용하여 측정 하여 이하의 결론을 얻었다.
(1) AlN 박막의 조직은 글래스 기판의 법선방향인 c 축, 즉 <00·1>방위를 갖는 주상정 조직이다.
(2) 주상정조직과 같이 배향성을 갖는 결정성박막에 대 한 X선 응력측정법을 제안하고, <00·1>방위를 갖는 AlN 박막의 잔류응력측정에 적용하였다.
(3) 00·2 회절 이외의 회절선에 대한 강도는 매우 미 약하였기에 AlN 분말시료를 비교 표준시료로서 사용하 여 응력측정을 실시한 결과, 질소가스압력이 낮은 경우 에는 인장잔류응력이었지만, 가스압력이 높아짐에 따라 잔 류응력은 압축잔류응력 쪽으로 이동하였다.
(4) 낮은 가스압력 상태에서는 과승인 질소원자의 혼 입에 의해 단위정이 팽창한다.